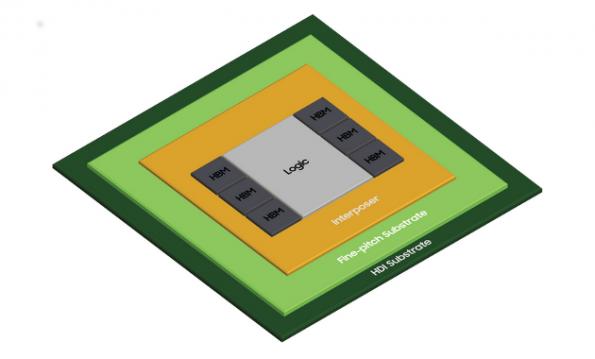
三星电子使用三芯片的新一代2.5D包装,拥有三星电机(Semco)和包装公司Amkor Technology。
混合衬底立方体(H-CUBE)技术使逻辑芯片或高带宽存储器(HBM)能够以小形状因子放置在硅中介层的顶部。三星的H-Cube技术具有混合基板与能够精细凸块连接的细间距基板,以及高密度互连(HDI)衬底,以实现大尺寸进入2.5D包装。
当集成六个或更多的HBMs时,制造大面积衬底的难度和成本迅速增加,导致效率降低。三星电子利用在高端细间距衬底上叠加大面积容易实现的HDI衬底的“混合衬底结构”解决了这一问题。
通过减少电连接芯片和基板的焊球的间距,与传统球间距相比,可以最小化细间距基板的尺寸,同时在罚款下添加HDI基板(模块PCB)- 用于确保与系统板连接的基板。
此外,为了提高H-Cube解决方案的可靠性,三星电子还采用了自主研发的信号/功率完整性分析技术。该技术可以在叠加多个逻辑芯片和hbm时,最大限度地减少信号损耗和失真,同时稳定地供电。
三星电子代工营销本部长姜文洙(音)表示:“与三星电子和Amkor技术共同开发的H-Cube解决方案,适用于需要集成大量硅片的高性能半导体。”“通过扩大和丰富铸造生态系统,我们将提供各种一揽子解决方案,以在客户面临的挑战中找到突破口。”
“这一发展降低了环保署/ AI市场进入的障碍,并展示了铸造和外包半导体装配和试验(Osat)公司之间的成功合作和伙伴关系,”Amkor Technology全球研发中心高级副总裁Jinyoung Kim表示。
相关链接和文章:
新闻文章:
- 三星改善了基于插入器的包装
- 英特尔在芯片封装上投资了35亿美元
- 2021年的TSMC准备“巨钟”风格制造
- 报告:台积电,日本分享东京芯片设施的成本
- X-Fab通过X-Celeb印刷过程提供小芯片支撑
- 精通芯片的台积电将斥资100亿美元建造组装和测试工厂
关于Eenews欧洲的其他文章






